深光谷科技发布飞秒激光直写三维光波导芯片,推动玻璃基高密度光互连产品应用于智算集群
深光谷科技通过持续的自主创新,成功研发了全国产化的飞秒激光直写设备及其光波导加工工艺。通过精准控制加工参数,如预整型光束、单脉冲能量和扫描速度等,公司在硼铝硅酸盐玻璃中加工出具有可控截面形貌、高对称模场和高均匀性的小型化、低损耗三维光波导多芯光纤耦合芯片,建立了完整的芯片生产和性能测试平台,具备批量生产和交付多芯耦合芯片的能力。产品的传输损耗低至0.1 dB/cm,端面插入损耗为0.3 dB/面。
2024.05.07编辑:深光谷小编阅读:6304
近日,高密度光电集成和光通信技术解决方案供应商—深圳市深光谷科技有限公司(简称:深光谷科技),取得玻璃通孔光电转接(TGV Interposer)技术重要突破。深光谷科技联合上海交通大学和深圳大学,合作开发了晶圆级TGV光电interposer工艺,实现了国产首个8英寸晶圆级TGV interposer加工,实测带宽达到110GHz,可以面向2.5D和3D光电集成封装应用,为VCSEL、DML、EML、硅光、铌酸锂等技术路线的光模块产品提供高速、高密度、高可靠性和低成本的光电共封装(CPO)解决方案。


图片1-TGV晶圆和interposer芯片
玻璃基先进封装技术近年来受到高度关注,在集成无源器件(IPD)、微显示、AR/VR等领域具有突出应用优势。玻璃具有天然友好的光学性质,采用激光诱导刻蚀可以实现高深宽比的玻璃通孔加工,并且能够支持大尺寸晶圆级和面板级加工,其稳定的光电性质也带来了高可靠性的优点。2023年9月18日,英特尔推出了玻璃基板封装的最先进处理器,计划于2026~2030年量产,基于玻璃基板设计的共同封装光学元件技术(CPO)也将在数据中心、人工智能和图形构建等场景带来颠覆性应用。
深光谷科技所开发的TGV光电interposer采用激光诱导刻蚀结合多层重布线(RDL)工艺,通孔深宽比4:1,基板厚度230um,表面平整度1.2um,支持2+1层RDL,挖槽深度60um,支持光纤阵列的耦合对准,支持电芯片flipchip封装,支持EML/SOA/硅光/铌酸锂等光芯片植球倒装,实测通孔和RDL布线带宽超过110GHz。
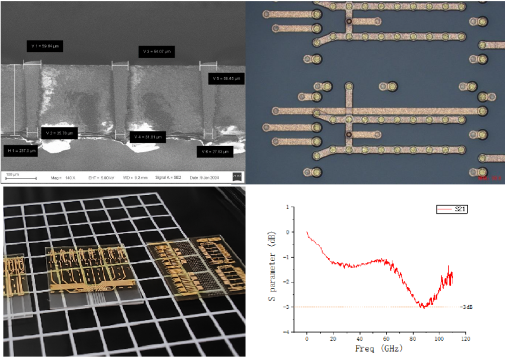
图片2:通孔电镜结构、RDL结构、interposer芯片、S21曲线
深光谷科技专注于光传输和光互连的高密度光电集成芯片、光连接器和光纤链路技术,玻璃基光电转接技术(TGV Interposer)将进一步与深光谷高密度空分复用技术结合,在玻璃激光直写光连接器、空分复用技术扇入扇出器件等方面形成对接,从而发挥出全链路高密度的优势,支撑数据中心、算力集群、大容量传输等领域的广泛应用。

深光谷科技是由国家级高层次人才团队创立的,专注于高速光通信技术开发与应用的国家高新技术企业。核心团队成员具有新加坡南洋理工大学、香港科技大学、美国哈佛大学、英国剑桥大学等国(境)外知名高校的留学经历,在纳米光子器件设计与开发、光通信、光学传感与成像等领域的研究处于世界领先水平。公司致力于开发面向AI算力集群、数据中心、5G通信、星链的高密度、低功耗、大容量光通信技术,以自研光电共封装interposer芯片和空分复用光芯片为核心,利用前沿的纳米光子学技术,结合人工智能、深度学习等新型光器件设计方案,为大模型人工智能及5G+时代急剧增长的数据通信容量需求提供最先进解决方案。核心技术包括空分复用光通信技术、共封装(CPO)光电集成互连、卫星激光通信等,核心产品有模式复用光芯片和器件、多芯光纤扇入扇出芯片和器件、CPO光电集成互连interposer芯片、卫星激光通信收发芯片等,拥有数十项国家发明专利。成果获得中国专利优秀奖、中国光学十大进展、教育部自然科学奖等。

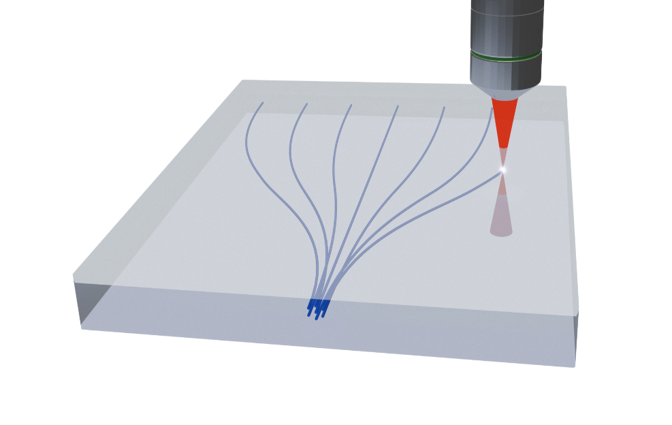
深光谷科技通过持续的自主创新,成功研发了全国产化的飞秒激光直写设备及其光波导加工工艺。通过精准控制加工参数,如预整型光束、单脉冲能量和扫描速度等,公司在硼铝硅酸盐玻璃中加工出具有可控截面形貌、高对称模场和高均匀性的小型化、低损耗三维光波导多芯光纤耦合芯片,建立了完整的芯片生产和性能测试平台,具备批量生产和交付多芯耦合芯片的能力。产品的传输损耗低至0.1 dB/cm,端面插入损耗为0.3 dB/面。

2023年6月5-7日,深光谷科技参加了由光纤在线在苏州主办的光连接大会,本次公司携多芯耦合芯片、模式复用器等多款产品参展,其中,产品模式复用器获得2023年度最具影响力产品创新奖。